「加三嘻行動哇 Yipee! 成為好友」
【Facebook、Youtube、Twitter、Instagram、Telegram、Line】

Intel 英特爾公司詳盡揭露其製程與封裝技術的最新路線規劃,並宣布一系列基礎創新,為2025年及其之後的產品注入動力。同時 Intel 英特爾也宣布製程節點將採用全新的命名結構,創造清晰並具備一致性的架構。
英特爾執行長Pat Gelsinger 基辛格表示,這次所揭曉的各種創新,不僅開展了英特爾的產品路線規劃,它們對於我們晶圓代工的客戶也相當重要。

英特爾技術專家們以新的節點命名方式,詳述未來製程與效能藍圖規劃,以及各節點所具備的創新技術:
- Intel 7:植基於 FinFET(鰭式場效電晶體)最佳化,相較 Intel 10nm SuperFin 每瓦效能可提升大約 10%~15%。Intel 7 將會使用在 2021 年的 Alder Lake 用戶端產品,以及 2022 年第一季量產的 Sapphire Rapids 資料中心產品。
- Intel 4:全面使用極紫外光(EUV)微影技術,透過超短波長的光,印製極小的形狀。伴隨每瓦效能提升約 20%,以及面積改進,Intel 4 將於 2022 下半年準備量產,2023 年開始出貨,client 用戶端 Meteor Lake 和資料中心 Granite Rapids 將率先採用。
- Intel 3:進一步汲取 FinFET 最佳化優勢與提升EUV使用比例,以及更多的面積改進, Intel 3 相較 Intel 4 約能夠提供 18% 的每瓦效能成長幅度。Intel 3將於2023下半年準備開始生產。
- Intel 20A:以 RibbonFET 和 PowerVia 這 2 個突破性技術開創埃米(angstrom)時代。RibbonFET 為英特爾環繞式閘極(Gate All Around)電晶體的實作成果,也將是自 2011 年推出 FinFET 後,首次全新電晶體架構。此技術於較小的面積當中堆疊多個鰭片,於相同的驅動電流提供更快的電晶體開關速度。PowerVia 為英特爾獨特、業界首次實作的背部供電,藉由移除晶圓正面供電所需迴路,以達最佳化訊號傳遞工作。Intel 20A預計將於2024年逐步量產,英特爾也公布 Qualcomm 將採用 Intel 20A 製程技術。
- 2025與未來:Intel 20A 之後,改良自 RibbonFET 的 Intel 18A 已進入開發階段,預計於 2025 年初問世,將為電晶體帶來另一次的重大性能提升。英特爾也正在定義、建立與佈署下一世代的 EUV 工具,稱之為高數值孔徑 EUV,並有望獲得業界首套量產工具。英特爾正與 ASML 緊密合作,確保這項業界突破技術能夠成功超越當代 EUV。
英特爾表示擁有基礎製程創新的悠久歷史,推動產業前進並破除限制。在 90 奈米領銜轉換至應變矽,於 45 奈米採用高介電常數金屬閘極,於22奈米導入鰭式場效電晶體,Intel 20A 將會是另外一個製程技術的分水嶺,提供2個突破性創新:RibbonFET 和 PowerVia。
英特爾新的 IDM 2.0 策略,對於實現摩爾定律優勢而言,封裝變得越來越重要。英特爾宣布 AWS 將是第一個採用 IFS 封裝解決方案的客戶,並同步提供下列先進封裝藍圖規劃的遠見。
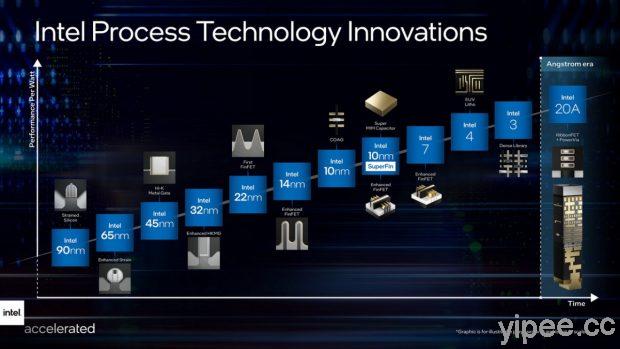
- EMIB:自2017年產品出貨開始,以首款5D嵌入式橋接解決方案持續引領產業。Sapphire Rapids 將會是首款量產出貨,具備 EMIB (embedded multi-die interconnect bridge) 的 Intel Xeon 資料中心產品。它也會是業界首款具備 4 個方塊晶片的裝置,提供等同於單一晶片設計的效能。Sapphire Rapids 之後,下一世代的 EMIB 將從 55 微米凸點間距降至 45 微米。
- Foveros:汲取晶圓級封裝能力優勢,提供首款 3D 堆疊解決方案。Meteor Lake 將會是Foveros在client用戶端產品實作的第二世代,其具備36微米凸點間距,晶片塊橫跨多種製程節點,熱設計功耗從 5 至 125 瓦。
- Foveros Omni:採用晶片與晶片連結與模組化設計,提供不受限的靈活高效能 3D 堆疊技術。Foveros Omni 允許混合多個頂層晶片塊與多個基底晶片塊,以及橫跨多種晶圓廠節點的分拆晶片(die disaggregation)設計,預計將於 2023 年準備大量生產。
- Foveros Direct:為降低互連電阻,改採直接銅對銅接合技術,模糊了晶圓製造終點與封裝起點的界線。Foveros Direct 能夠達成低於 10 微米的凸點間距,提升 3D 堆疊一個量級的互連密度,為原先被認為無法達成的功能性晶片分割開啟新頁。Foveros Direct 是 Foveros Omni 的補充技術,同樣預計於 2023 年問世。
延伸閱讀:
華碩推出一體式水冷 CPU 散熱器,具備高性能風扇與自訂燈效
Western Digital 推出嵌入式快閃儲存 UFS 3.1 平台,支援行動裝置、汽車、無人機等智慧互聯行動技術
圖片及資料來源:Intel 英特爾
|
|

